光电传感器WL-CSP封装芯片底部填充胶应用
时间:2023-05-18 | 栏目:光电显示 | 点击:次
光电传感器WL-CSP封装芯片底部填充胶应用由汉思新材料提供
经过联系客户工程技术和研究其提供的封装工艺流程。
了解到以下信息。
客户用胶项目是:光电传感器芯片(CCD),是WL-CSP封装类型的芯片,
用胶位置是BGA芯片底部填充
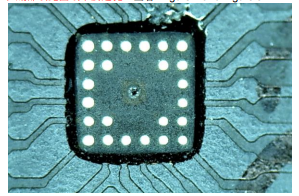
汉思BGA芯片底部填充胶应用
客户芯片参数:
芯片主体厚度(不包含锡球):50微米
因为有好几种芯片,现在可以确定的是
球心间距:450微米
焊盘直径:300微米
焊盘间隙宽度:150微米
客户产品要求:
可以承受的最高固化温度:120摄氏度
以前的用胶是日本品牌
其粘度为700cps,应用在该上的固化条件是120@1h
换胶原因是因为选择全面现实国产化,据悉是华为项目。
汉思新材料推荐用胶:
已推荐客户购买汉思HS710底部填充胶用于批量试胶。批量生产数量为1K。