Maxim晶片级封装安装指南
时间:2009-04-21 | 栏目:制造与封装 | 点击:次
摘要:晶片级封装(WLP)允许集成电路(IC)面向下安装在印刷电路板(PCB)上,芯片的焊盘通过单独的焊点与PCB连接。本文讨论了晶片级封装技术及其优势,描述了Maxim WLP的PCB布局和安装流程。
晶片级封装(WLP)用单独的焊点将集成电路(IC)与印刷电路板(PCB)连接在一起。IC面朝下安装,这种技术不需要任何绑定线或引线,有别于其他球珊阵列、引脚封装和压层CSP封装技术,是IC与PCB之间电感最小的封装形式,这也是它最主要的优点。另外,这种封装大大缩小了封装尺寸,缩短了制造周期,并增强了热传导特性。
本文描述了Maxim WLP的PCB布局和安装流程,注意,这里给出的只是基本的PCB布板设计和安装指南,并不保证用户最终产品的可靠性,用户还需要对其最终产品的使用寿命和可靠性进行验证。
封装结构
Maxim封装图WLP焊点的相互连接是在硅晶片的基板上构建起来的,晶片电路的表面覆盖了一层BCB (Benzocyclobutene)树脂薄膜,这层薄膜可以减缓凸点的机械应力,并为裸片表层提供电气隔离。过孔成像在BCB膜上,与IC绑定焊盘提供电气连接。UBM层(焊点下的金属化层)覆盖在过孔上方,BCB层的另一个作用是焊料掩膜,定义回流焊球的直径和位置。目前封装I/O的设计包含2至55个可焊接点,如图1所示。标准的焊点合金是易于溶解的Sn63Pb37、“高铅含量”Pb95Sn5和“无铅”Sn96.5Ag3Cu0.5,单个WLP焊点的结构如图2所示,元件背面是裸露的硅片,带有一个光刻的引脚1标记和标示码。双金属层分区工艺(RDL)允许从外围绑定盘移至其他凸点矩阵模板。
图1. 通用的2焊点CSP、55焊点倒装芯片、4 x 4 UCSP™
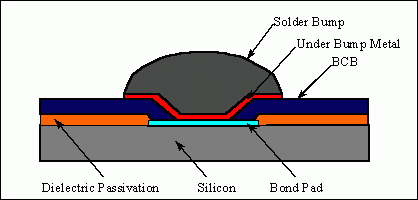
图2. 通用WLP结构图
WLP载带
WLP采用卷带(T&R)形式包装,卷带规格符合EIA-481和EIA-746&747标准。图3给出了典型的卷带结构,所有Maxim的倒装芯片和CSP器件采用浮凸载带包装,带有压封胶粘(PSA)封带,卷轴为7英寸或13英寸。也可以根据用户需求提供Surftape®或Surftape-Lite®卷带及其他尺寸的卷轴。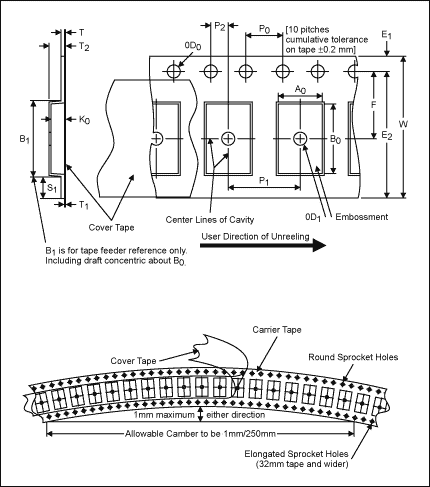
图3. 典型WLP载带结构
焊球在卷带内面朝下放置,卷带的每个包装内引脚1的位置保持一致。封带的总剥离强度在0.1N至1.0N (10gf至102gf标定刻度)。
PCB布局
PCB设计需要符合IPC-A-600和IPC-6012A标准,标准的FR4 (Tg = 120°C至150°C)覆铜层压板可能适用于峰值温度达240°C的全部回流焊流程;对于峰值温度在240°C至270°C范围的回流焊工艺,建议使用高性能FR4或BT层压板(Tg = 170°C值185°C)。对于Maxim的焊点合金材料,无电镀镍浸金(ENIG)是PCB铜基板焊盘表面抛光的首选电镀处理方法(在最小100微英寸/最大300微英寸厚度的Ni上覆盖最小3微英寸/最大20微英寸厚度的Au),铜焊盘上也可以使用有机表面保护(OSP)层。对于所有球栅阵列封装的焊点,非焊锡掩膜法(NSMD)焊盘优于焊锡掩膜法(SMD)焊盘。焊盘之间建议使用焊盘掩膜法,利用焊盘掩膜设计清空0.002"至0.003"的焊盘边缘。采用层叠焊点回流(易溶的Sn-Pb和无铅)处理时,焊盘尺寸通常比最大焊点直径小20至25%,保证焊接深度达到最大元件焊点高度。采用非层叠焊点回流(高铅含量)处理时,焊盘尺寸通常比最大焊点孔径大0.002"至0.004",对于焊点沉浸度和可接受度可以利用X射线检查。对于“高铅含量”焊盘设计的唯一例外是Maxim的2焊点CSP封装(图1),对于这种封装形式,建议使用1:1最大焊点孔径的焊盘,以防止回流焊时由于管芯的倾斜造成焊点的连接。基板模板可以是圆形的或方形的,焊盘和连线应该对称排列,以避免回流焊中产生偏离中心的拉力。为防止虚焊,每个NSMD焊盘应该由一条线连接,引线宽度不要超出所连接的NSMD焊盘孔径的1/2。
应谨慎选择WLP元件在PCB上的位置,如果相邻元件具有较高的封装外形,则会遮蔽WLP封装,避免潜在的错误连接。
PCB安装流程

焊膏印刷工艺
焊膏印刷是与PCB装配产出率相关的最重要的工艺。必须检查焊膏厚度、焊盘覆盖百分比和与焊盘的对准精度。- 选择焊膏:应使用第3类(锡球尺寸为25至45微米)或第四类(20至38微米)的锡膏,选择哪一类取决于模板开孔的尺寸。建议使用低卤化物含量(< 100ppm)和免清洗的、J-STD-004指定的ROL0/REL0树脂助焊剂,可以省去回流装配后的清洗工作。
- 制作模板:使用激光切割不锈钢箔片加电抛光技术或镍金属电铸成形的制作工艺。镍电铸成形工艺虽然比较昂贵,但是对于从超小的开孔进行焊膏沉积的过程最具可重复性。这种方法还有一个优点,可以形成任何用户所需要的厚度。具有梯形截面的模板开口有助于焊膏的释放。
- 焊锡模板开口设计:对于激光切割SS使用纵横比为≥ 0.75的孔径;对于镍金属电铸成形,使用纵横比为≥ 0.66的孔径,方圆形(25微米角径)开口有助于焊膏沉积的重复性。孔径纵横比定义为孔径开口面积除以孔径边缘的面积。也可以使用偏离基板焊盘的X、Y坐标轴,使每个焊点的粘贴沉积度最强,焊点之间的影响最小,如图4、图5所示。
- 焊锡模板的厚度:焊锡模板的厚度应该不超过焊点的高度,必须达到实际孔径设计所对应的纵横比的要求。在采用混合技术的PCB装配中,如果这些模板要求与其他SMT元件的要求相冲突,可以使用符合IPC-7525设计标准的低一级的模板工艺或双印刷模板工艺。
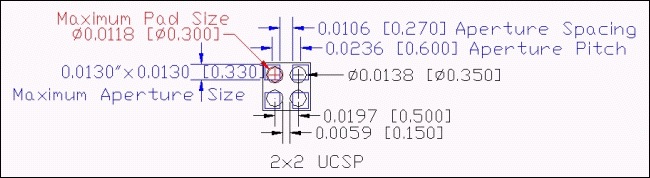
图4. 2 x 2 UCSP孔径焊点的模板设计范例
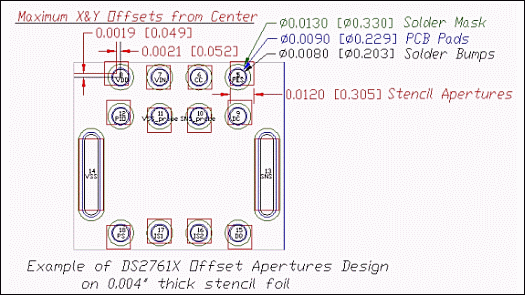
图5. DS2761X倒装芯片孔径焊点的模板设计范例
元件的放置
Maxim的所有WLP硅片均采用真空吸头从载带包装中取出,并贴放到PCB上,这一过程使用标准的自动精确定位IC拾取/贴放机完成,在4σ下的贴放精度≤ 0.050mm。拾取/贴放系统需要一个固定的卷带送料器。使用机械中心定位方案的系统是不可取的,因为它极有可能损坏硅封装。- 拾取/贴放系统的贴放精度依赖于它使用的是封装外形中心与球栅阵列中心的视觉定位技术。排列精度要求较低时,封装外形中心对准可以用于高速贴放;球栅阵列中心排列能够在贴放速率较低时实现最大的对准精度。封装外形对准与球栅阵列对准的中心位置座标X、Y最大可相差±0.035mm。
- 焊点贴放位置与PCB焊盘中心的最大允许偏移在X、Y方向均为±0.100mm,这样可以保证回流过程的沉浸力使焊点自动对准中心。
- 所有硅裸片封装的接触力应该控制在≤ 2牛顿(204gf)以内。精确的分布力度应该周期性地利用经过校准的测压表进行测试。
- 需要使用2D X射线测量并验证贴放精度。
焊膏回流
Maxim的WLP符合工业标准回流焊处理流程,我们选择氮惰性气体下的回流焊接。- 推荐使用压迫气体对流回流炉,这样可以控制整个过程中的热传导率。
- WLP焊点能够经受三个标准回流焊周期。
- 推荐使用2D X射线或3D X射线分层摄影法作为回流焊之后取样检验,检查焊结短路、焊锡不足、漏焊和潜在开路等问题。-00
- 易溶解的Sn-Pb焊膏回流到易溶解的Sn-Pb或“高铅含量”焊点的WLP:标称峰值温度是220°C ±15°C,高于183°C熔点温度的持续时间是60 ±15秒,由机械装置内部的热电偶测量和验证回流炉的温度特性。典型的易溶Sn-Pb焊膏回流焊温度曲线如图6所示。峰值温度上限建议用于易溶Sn-Pb焊膏回流到“高铅含量”焊点的WLP中,以增强焊点接口处金属间的绑定层。
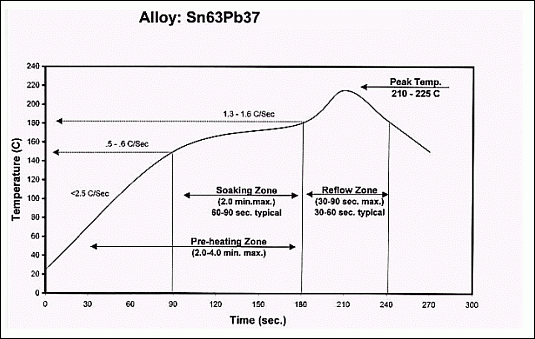
图6. 易溶焊膏的典型温度特性曲线
- “无铅”焊膏回流焊:标称峰值温度为250°C ±10°C,高于217°C至221°C熔点温度的时间是60 ±15秒,由机械装置内部的热电偶测量和验证回流炉的温度特性。对于Sn96.5Ag3.5和SnAg(2-4)Cu(0.5-0.8)合金的典型“无铅”焊膏回流焊温度曲线如图7所示。

图7. Sn96.5Ag3.5和Sn-Ag-Cu“无铅”焊膏的典型温度特性曲线
元件更换
WLP的更换方法与典型的球栅阵列(BGA)更换方法相同。- 使用局部加热取走WLP元件,加热温度曲线与最初的回流温度曲线类似,使用对流热气体喷嘴和底部预热的方法。
- 当喷嘴温度超过焊点熔点时,使用塑胶镊子或者真空工具取走有缺陷的元件。
- 必须使用温度可控的烙铁除去焊盘上的残留锡料。
- 将凝胶状助焊剂涂到焊盘上。
- 用真空拾取工具拾起新元件并利用视觉定位贴放夹具将其精确地放置在电路板上。
- 用相同的对流热气体喷嘴和底部预热的方法对元件进行回流焊接,采用最初的回流温度曲线。
环氧包封(板上安装倒装芯片所必需的)
为了提高焊点连接的机械强度,加速热循环(ATC)能力,可以在安装了的CSP电路增加环氧填充和/或Glob-Top包封,使测试可靠性比没有环氧包封的元件提高10倍。这种“包封效应”可以提高芯片与基板之间环氧粘合剂的机械连接机制的性能。环氧包封还为潮湿的环境以及化学污染提供了一层物理屏障。另外,环氧填充还可以阻止焊膏在相邻焊点之间蔓延,Glob-Top环氧层可以防护WLP的边缘和背面硅层的机械连接处不被损坏。材质的考虑
- 固化环氧剂的线性扩充系数(CTE)与焊接点、Sn63Pb37 (21ppm/°C) - Pb95Sn5 (29ppm/°C)、65%至70%硅填充料一致。
- 较高的玻璃化转变温度(Tg)改善了所有产品保存期内的温度需求(最小固化环氧Tg ≥ 基板Tg; FR4 = 120°C至135°C, BT/强化FR4 = 170°C至185°C)。
- 支持BCB钝化和LPI焊锡掩膜。
- 低Ionics, 总卤化物低于100ppm。
- 低粘连性、快速回流率,回流能力可达到50mm (2mil)最小间隙尺寸。
- 低扭曲度,低收缩率。
- 低吸潮性。
可接受的视觉核查标准
- 环氧填充材料必须连续地环绕整个管芯的四周构成一个正倒角,不允许有空隙。这个正倒角与管芯的底层边沿有一个最小连接高度,连接高度不要超出管芯顶层边沿。另外,倒角必须为正的润湿角,使管芯边沿与外界隔离。
- 环氧表层从视觉上必须保持均匀,没有间隙和针孔。
- 环氧层不要粘接到任何装配电气插头的表面。
- 可以利用垂直扫描声波显微镜(C-SAM)成像作为填充空隙检测的分析方法,如图9、图10所示。
- 测量液化环氧分布重量的增加可作为监视SPC的简单方法。

图8. 环氧包封选项
图9. 垂直扫描声波显微镜(C-SAM)成像的例子
图10. 垂直扫描声波显微镜(C-SAM)成像的例子
包装与运输
为了防止损坏WLP元件,包装与运输WLP装配部件时必需小心,尤其是在不使用环氧包封安装WLP元件的情况下。必需评估并严格遵守装有WLP元件的PCB包装规格。UCSP是Maxim Integrated Products, Inc.的商标。